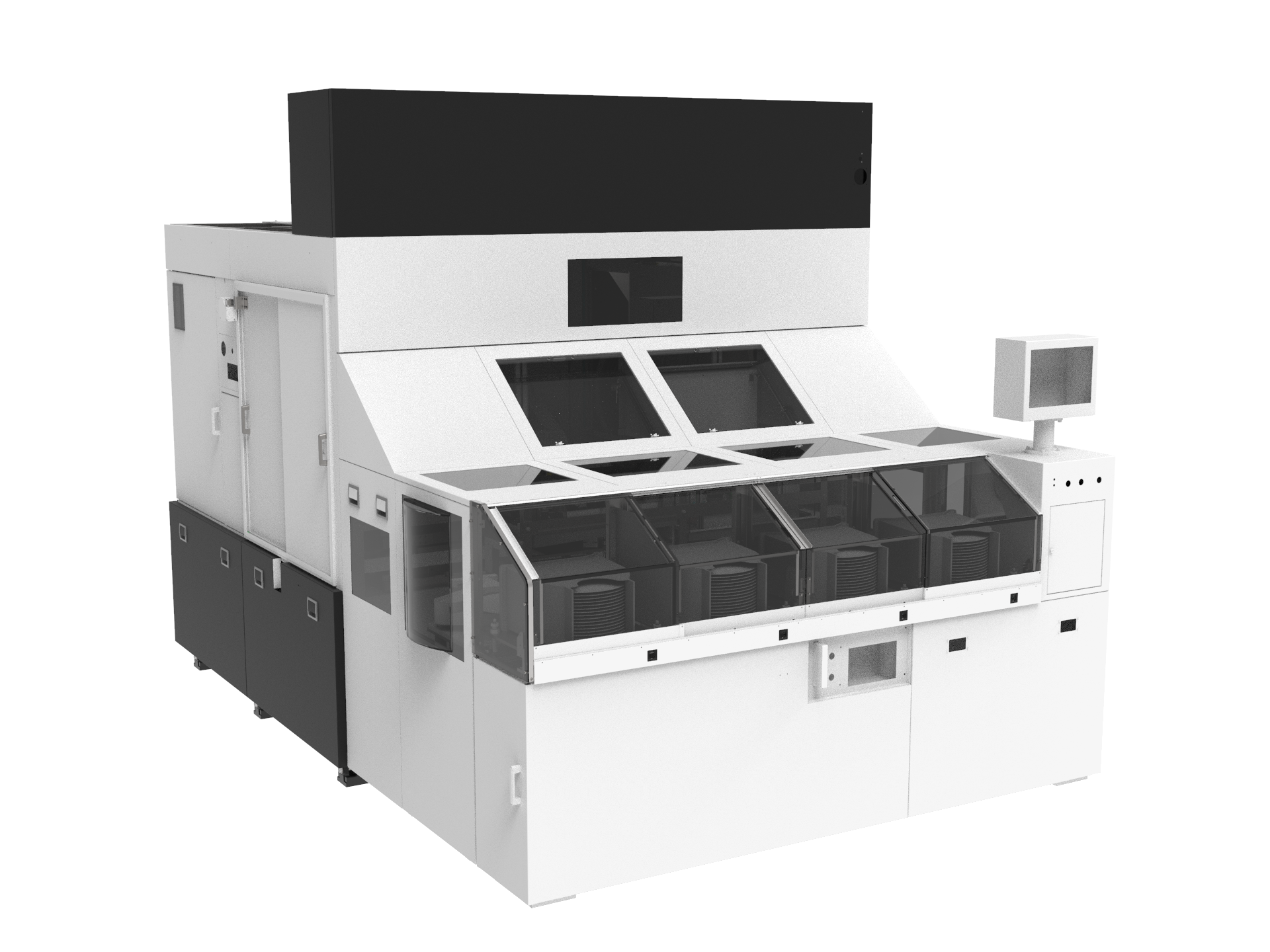




Machine tools
GCG300
Wafer manufacturing equipment
- Max workpiece size (in) Φ11.8
- Max workpiece size (mm) Φ300
- Processing method In-feed grinding
- Machine size (W x D x H) (in) 93.3 x 137.8 x 98.4
- Machine size (W x D x H) (mm) 2,370 x 3,500 x 2,500
Purchase options
Contact usFully automatic surface grinder pursuing high flatness and low damage
- High flatness grinding
- Low-damage grinding by ductile mode machining
- Improving production efficiency through IT
Resources
Features and benefits
High planarization grinding
The unique horizontal machining unit structure achieves high rigidity and low thermal displacement. Stable high flatness can be achieved in continuous grinding of silicon wafers. It can also be used for machining with a high number of grinding wheels and for machining difficult-to-machine materials.
Improving production efficiency through IT
By locally connecting the main unit of the surface grinder to a PC for data collection, trends such as grinding wheel wear, chuck adsorption pressure, grinding water volume, and motor current can be analyzed, contributing to stable production of wafers. The communication protocol is SEMI standard (GEM) compliant. Communication of processing data is possible through a network connection with a host PC. OHT (Over Head Transfer) workpiece loading is supported, enabling unmanned processing from workpiece delivery to processing.
Low-damage grinding by ductile mode machining
Ductile mode grinding is realized by adopting air hydrostatic pressure for the grinding wheel and chuck spindle, high loop rigidity, and nano-level micro feed. This enables low-damage grinding of wafers and reduces the load on the polishing process.
Specifications
- Full specs
- Machine size (W x L x H) (mm): 2,370 x 3,500 x 2,500
- Machine size (W x L x H) (in): 93.3 x 137.8 x 98.4
- Target workpiece dimensions (mm): Φ300
- Target workpiece dimensions (in): Φ11.8
- Grinding wheel spindle speed (min-1): 600-3,000
- Chuck spindle speed (min-1): 0-450
- Grinding wheel feed axis stroke (mm): 120
- Grinding wheel feed axis stroke (in): 4.7
- Number of chuck tables: 2
- Number of cassettes: 4
- Specialties: Ultra-precision surface grinder for semiconductors